Neue Charakterisierungsverfahren für die Oberflächenbearbeitung
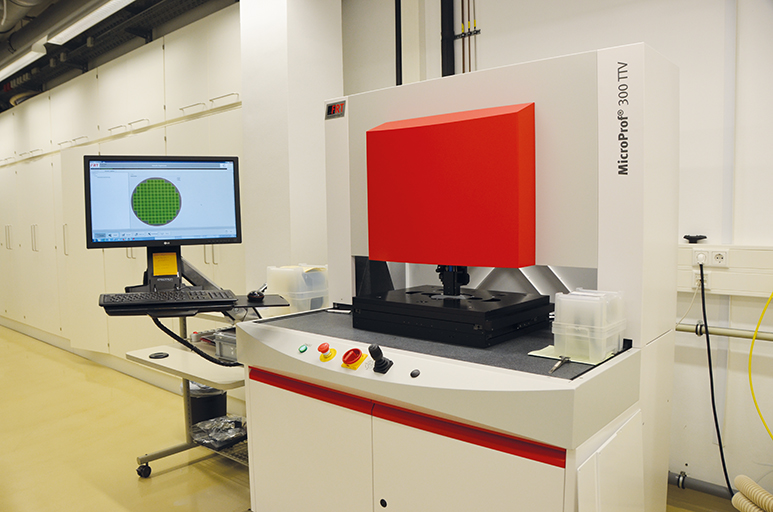
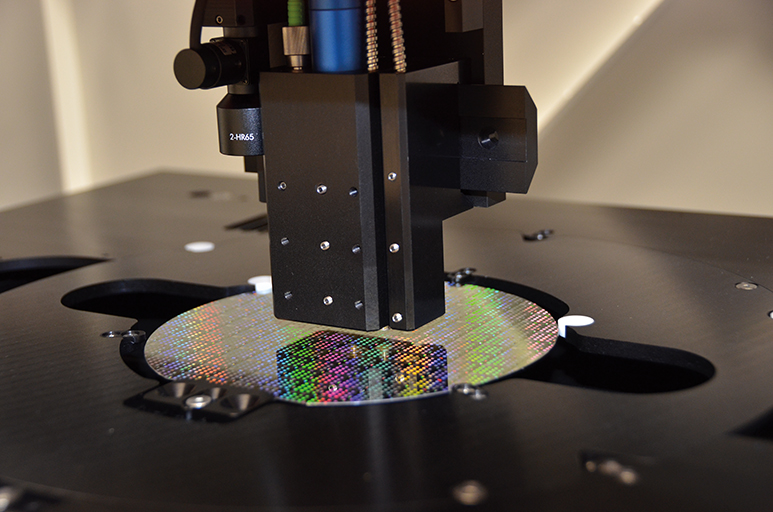
Prozesse der Oberflächenbearbeitung, wie Grinden oder chemisch-mechanisches Polieren, sind heute elementare Basistechnologien in der gesamten Halbleiterfertigung. Getrieben von »More Moore«- und »More than Moore«-Anwendungen steigen die Anforderungen an deren Prozessqualität kontinuierlich, was eine entsprechende Prozesskontrolle erfordert. Mit dem »UnitSC4see« steht ein Inspektionssystem zur Verfügung, das mittels Streulichtmessung Partikel und Oberflächendefekte bis kleiner 100 nm (Limit bei ca. 60 nm) detektieren kann. Ein zusätzliches 2D/3D-Modul zur mikroskopischen Hellfelderkennung von Strukturdefekten ermöglicht die Bewertung der Polierergebnisse an realen Bauelementwafern. Ergänzt wird dieses Messgerät durch ein Geometrie- und Schichtdickenmessgerät »FRT MicroProf300TTV«. Dieses gestattet mittels chromatischer Weißlichtsensoren die Bestimmung u. a. von Substratdicken, Dickenabweichungen (TTV), Bow und Warp. Ein Dünnfilm-Weißlicht-Reflektometer sowie ein Infrarot-Interferenz-Sensor ermöglichen sowohl Dickenmessung für optisch transparente wie auch optisch undurchlässige Schichten oder Substrate.
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme