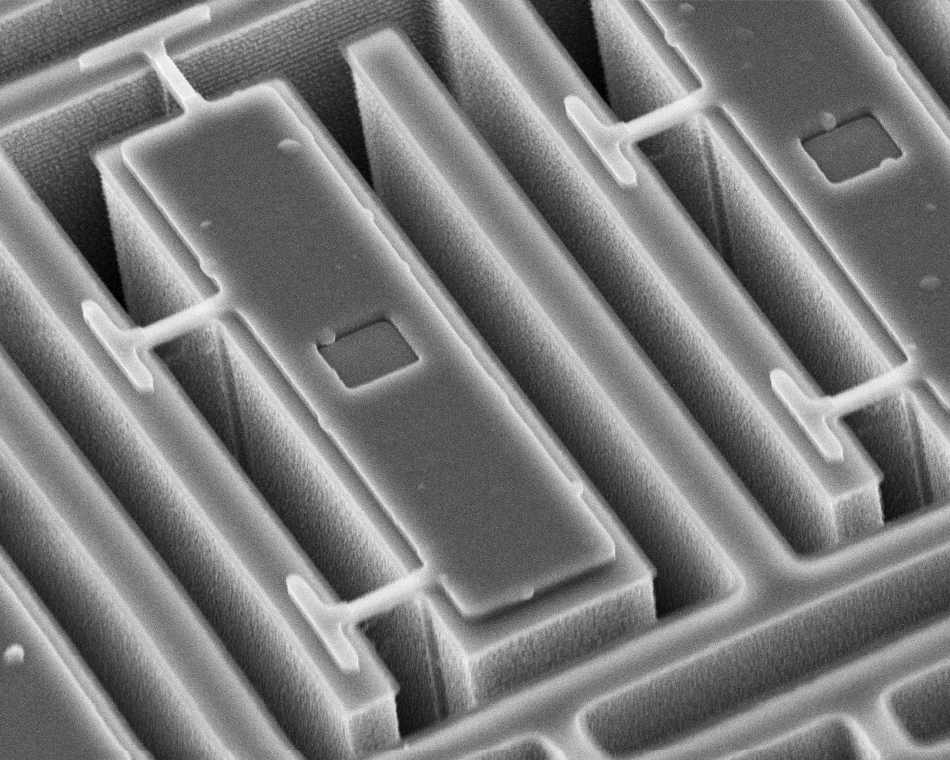
Diese Technologieplattform nutzt Standard-Si-Wafer und ermöglicht eine Strukturierung beweglicher Elemente von der Oberfläche ausgehend in den Si-Kristall hinein. Die elektrische und mechanische Kontaktierung der aktiven Strukturen erfolgt über eine Vielzahl von dünnen metallischen Verbindungselementen auf speziellen Träger-Schichtsystemen. Die elektrische Isolation wird in lateraler und vertikaler Richtung durch ätztechnisch erzeugte Luftspalte (airgaps) organisiert. Die mehrstufige Strukturierung nutzt ausschließlich Plasmaätzschritte, ist somit vollständig CMOS-kompatibel und wurde bereits als POST-CMOS MEMS-Prozess demonstriert. Die patentierte AIM*-Technologie ermöglicht insbesondere die Herstellung von elektrostatischen Aktuatoren und kapazitiven Sensoren für die präzise Detektion von sehr kleinen Bewegungen in bis zu 3 Dimensionen. Weitere Technologiepatente zur Zustellung von Elektroden nach der Prozessierung** und zum Laserschweißen nach der Zustellung*** ermöglichen eine nachträgliche Erhöhung des Aspektverhältnisses der Elektroden auf > 75:1 für eine deutliche Erhöhung der Sensitivität.
Die Verkapselung kann mittels Dünschichttechnologie bzw. mittels Waferbonden erfolgen. Neben der Standardvariante basierend auf einem glasfritt-gebondeten Deckelwafer mit Kontaktöffnungen wurden auch Technologievarianten mit vertikalen Durchkontaktierungen erprobt. Dabei kann der Innendruck in einem bestimmten Bereich den Erfordernissen der Anwendungen angepasst werden.
Anwendungsbeispiele sind z.B. MEMS-Inertialsensoren zur Messung von Neigung, Beschleunigungen und Vibrationen sowie Hochfrequenz-MEMS-Schalter.
*Patent AIM: DE 10029012C2; U.S.No.10/296,771;
**PCT/DE01/02237**Patent Gap reduction actuation: WO;
***2013/178343***Patents Laser welding: DE 10 2015 008 119.5
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme