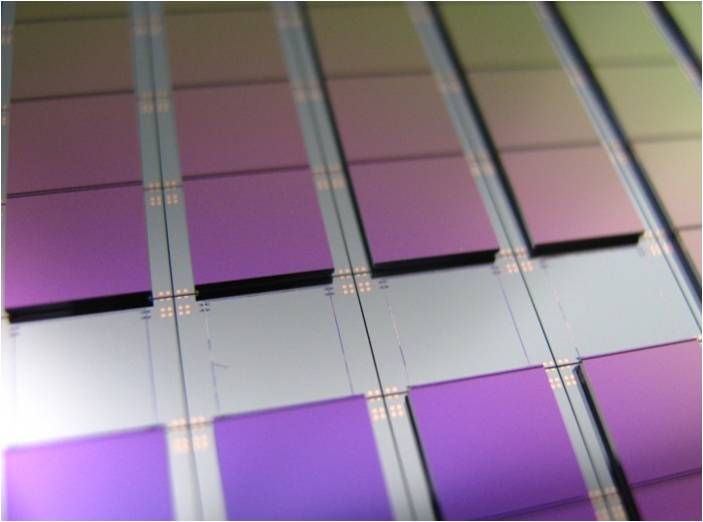

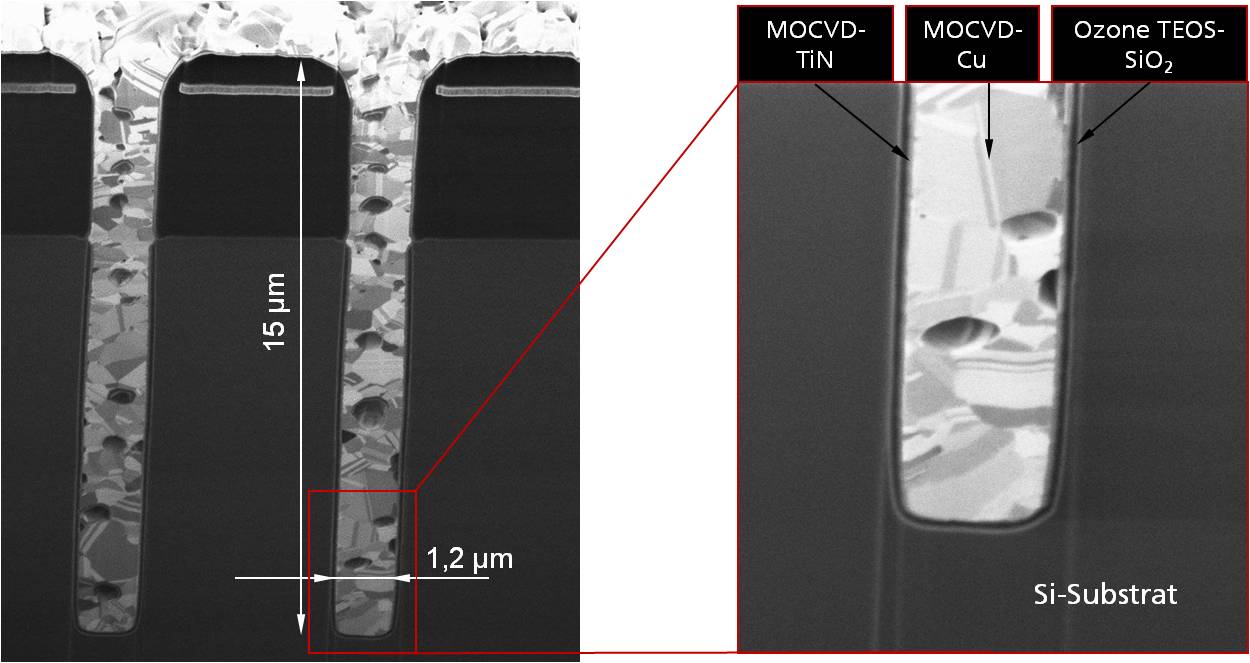
Für die Systemintegration wurden verschiedene Ansätze wie System-on-Chip (SoC), System-in-Package (SiP) oder System-on-Package (SoP), entwickelt. Neuartige SiP-Ansätze beziehen auch die dritte Dimension mit ein, was in komplexen Systemarchitekturen resultiert. Die 3D-Integration mittels Through Silicon Vias (TSV) oder Through Glas Vias (TGV) stellt dabei einen der vielversprechendsten Ansätze dar. Jedoch ist eine 3D-Integration über TSVs oder TGVs aufgrund der enormen Vielzahl von unterschiedlichen MEMS-Typen mit einer ebenso großen Breite an Fertigungstechniken, Materialkombinationen und Packaging-Verfahren, die auf kundenspezifischen Prozessen basieren, schwierig. Erschwerend müssen unterschiedliche Anforderungen bezüglich des Austauschs mit den Umgebungsmedien, wie z. B. Öffnungen für den atmosphärischen Druckausgleich bei Drucksensoren oder aber hermetischer Verkapselungen für Beschleunigungssensoren berücksichtigt werden. Dementsprechend lassen sich die fortgeschrittenen 3D-Integrationstechniken der Mikroelektronik nicht ohne weiteres auf MEMS übertragen. Vielmehr entwickeln sich für unterschiedliche Randbedingungen verschiedene Lösungsansätze für die Integration von MEMS. Im Allgemeinen besteht die 3D-Prozessabfolge aus vier Schritten:
- Formierung der Durchkontakte mit Tiefenstrukturierung und Isolation
- Metallisierung der Durchkontakte
- Waferabdünnen und Planarisieren
- Wafer- und/oder Chip-Bonden
Diese vier Schritte können in verschiedenster Reihenfolge kombiniert werden, sodass sich unterschiedliche Prozessabläufe ergeben.
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme