Thermomechanische Zuverlässigkeitsaspekte von Hochtemperatur-Verbindungen durch transientes Flüssigphasenlöten
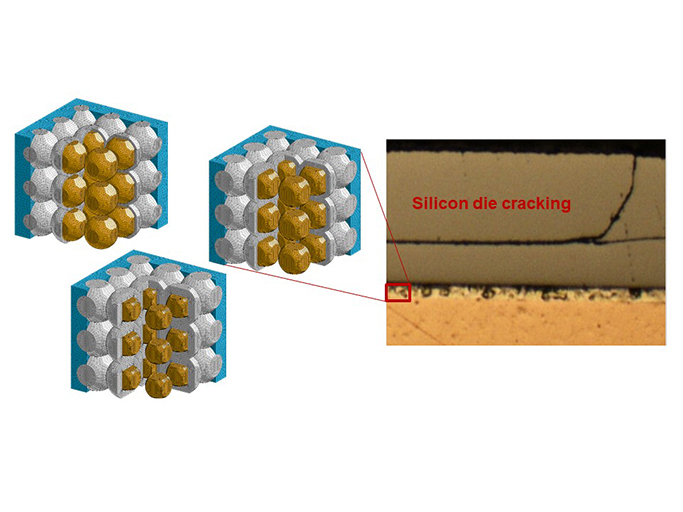
Die Erhöhung der maximalen zuverlässigen Betriebstemperatur ist ein Schlüsselfaktor für die Steigerung der Effizienz von Leistungsmodulen und Geräten, die bei zukünftigen Entwicklungen wie elektrischen Antriebssystemen, intelligenten Beleuchtungssystemen oder Energiemanagementsystemen eingesetzt werden. Parallel zur Entwicklung von Halbleitern mit höheren Betriebstemperaturen werden Verbindungstechnologien entwickelt, um Lösungen entlang der Wertschöpfungskette zu schaffen. Hochtemperatur-Verbindungstechnologien in Serienanwendung sind das Silbersintern, während andere Sintermaterialien oder Verbindungen, die auf der Bildung von intermetallischen Phasen (IMPs) basieren, noch in der Entwicklung sind.
Letztere Technologie kann in Form des transienten Flüssigphasenlötens (TLP-Löten) angewendet werden, d.h. die IMCs Cu6Sn5 oder Cu3Sn werden durch isotherme Erstarrung gebildet. Standard-Löttemperaturen von ca. 250 °C führen zu hochtemperaturfesten Verbindungen > 400 °C. Das Materialverhalten der intermetallischen Verbindungen unterscheidet sich jedoch von Weichloten oder Sintersilber. Insbesondere sind sie weniger duktil und es können sich nach der Verarbeitung oder im Betrieb hohe mechanische Spannungen aufbauen. Daher treten neue Zuverlässigkeitsprobleme aufgrund von weniger nachgiebigen Verbindungen auf, die zu Siliziumbrüchen oder Metallisierungs-Delaminationen führen können. Durch mikromechanische Modellierung können maßgeschneiderte transiente Flüssigphasenmaterialien designed werden, um das Ausfallrisiko zu reduzieren.
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme