
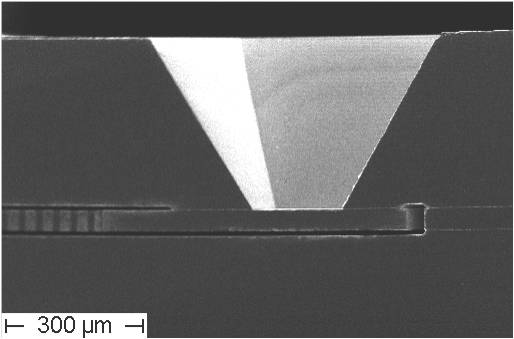

Einer der letzten Wafer-Level-Prozesse ist das Vereinzeln, wobei komplett prozessierte Wafer in kleine Chips separiert werden. Spezielle diamantbeschichtete Sägeblätter ermöglichen kleinste Prozessschnitte bei geringster Kantendeformation, was für nachfolgende Packagingprozesse von enormer Bedeutung ist. Mit der halbautomatischen Sägemaschine DAD-2HTM und der vollautomatischen Sägemaschine DFD6340 stehen in der Abteilung System Packaging für die Sägeprozesse zwei Geräte die Firma Disco zur Verfügung. Beide Maschinen verfügen über kraftvolle Einzel- und Doppelspindelsysteme und können zum Sägen von Materialien wie Silizium, Glass, Keramik oder Metallen genutzt werden. Dabei kommen Sägeblätter mit 2“ oder 3“ Durchmesser zum Einsatz, die in der Dicke zwischen 15 μm bis zu 500 μm variiert werden können. Die maximal prozessierbare Substratdicke beträgt 4 mm. Beide Maschinen können auch für das Sägen von gestapelten oder gebondeten Materialien wie Sensoren unter Aktuatorstrukturen mit verschiedenen Schichten Glas und Silizium eingesetzt werden. Das Doppelspindelsystem ist mit einer integrierten Reinigungseinheit, einer UV-Einheit und einem CO2 -Absorbtionsgefäß ausgestattet.
Materialien
- Si
- Gläser
- Metalle
- Keramiken
- Sondermaterialien
- Verbunde (Si-Glas, Glas-Glas, Si-Si)
Prozessführung
- Aufkleben auf Sägefolie (Klebefolien, UV-Folien, thermische Folien)
- Oberflächenschutz bei Bedarf
- Vakuumfixierung & Justage
- Programmierung der Sägevorschrift
- Automatisches Trennschleifen
Parameter
- Sägeblatt: 2“... 3“
- Substratdicken: bis 4 mm
- Justiergenauigkeit: 1...2 µm
- Schnittbreiten: 15...500 µm
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme