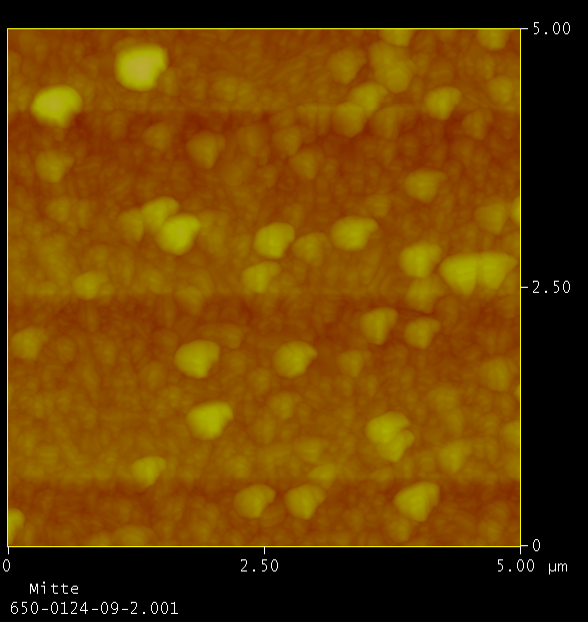
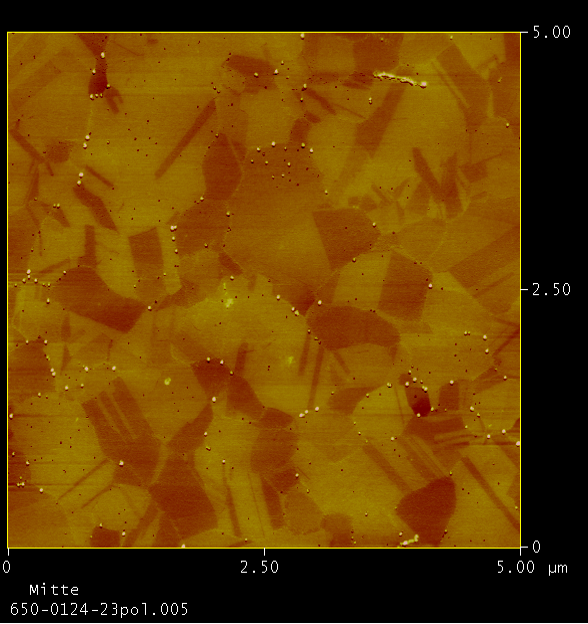
Beim Fügen von Substraten kommt der Oberflächenbeschaffenheit eine große Bedeutung zu. Während bei relativ dicken Zwischenschichten, wie Glaspaste oder Epoxy, die Rauheit der Oberflächen eine untergeordnete Rolle spielt, ist bei zwischenschichtfreien Verfahren der atomare Kontakt der Fügepartner von entscheidender Bedeutung. Anodische Bondverfahren erfordern Oberflächen mit einer Rauheit Ra <1 nm. Für andere Verfahren ist die Vorbehandlung durch spezielle Prozesse, wie Plasmaaktivierung, Hydrophilisierung oder chemisch mechanische Polierprozesse bedeutend.
Neben einer nasschemischen Wafervorbehandlung kann durch chemisch-reaktive Plasmaentladungen die Festigkeit von direkt gebondeten Materialverbünden gesteigert werden. Bei dieser Vorbehandlung, die sowohl ganzflächig als auch lokal möglich ist, können bei Auslagerungstemperaturen von lediglich 200 °C ähnlich stabile Bondverbindungen wie beim Hochtemperaturbonden erreicht werden. Dementsprechend können hiermit neuartige Materialien sowie bisher nicht bondbare, heterogene Materialpartner wie Lithiumtantalat und Silizium miteinander verbunden werden. Chemisch-mechanisches Polieren (CMP) wird sowohl für die Mikrosystemtechnik als auch im Bereich der 3-D-Integration entwickelt und angewendet. Wesentliche Herausforderungen und Untersuchungsgegenstände für das CMP sind die extremen Verhältnisse von Strukturabmaß zu Strukturabstand sowie vielfältige Materialien. Neben dem CMP von Aluminium, Kupfer; Gold, Edelstahl oder Germanium, das für Prozesse der 3-D-Integration untersucht wird, können auch Keramiken, verschiedene Gläser, Silizium oder Siliziumdioxid chemisch-mechanisch poliert werden. Anwendungsbeispiele sind die Herstellung neuartiger SOI-Substrate mit vergrabenen Silizid-Schichten, die für Bauelemente der BiCMOS-Technologie und für Hochtemperaturanwendungen benötigt werden.
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme