Low-k- und ultra low-k-Analytik
Das Fraunhofer ENAS bietet eine große Bandbreite an Methoden, um dichte und poröse low-k dielektrische Materialien zu analysieren. Dies beinhaltet unter anderem die Bestimmung von optischen, elektrischen, mechanischen, thermischen und strukturellen Materialeigenschaften.
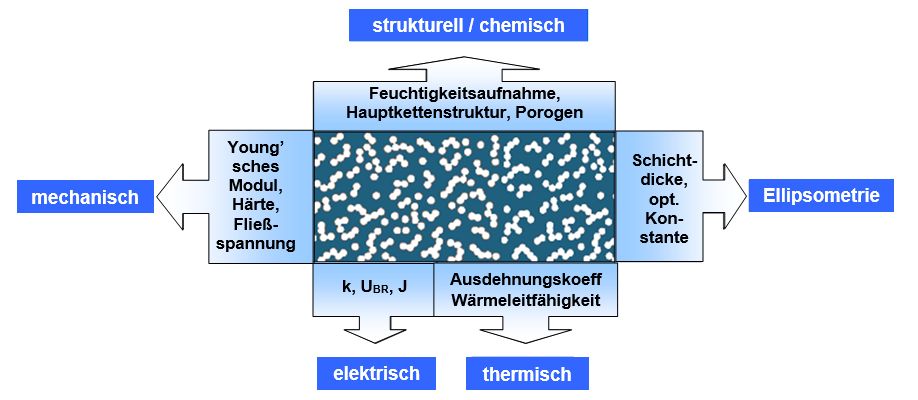
Spektralellipsometer: Sentech SE 850
- Spektralbereich: 190 nm – 2550 nm
- Einfallswinkel: 40° – 90°
- Substratgrößen: bis zu 300 mm
- frei programmierbare Mapping Skripte
- Bestimmung des Brechungsindex, der Schichtdicke und der Homogenität
Quecksilber-Sonde (CV-Messung)
- Anlage: Solid State Measurements SSM 495
- Substratgrößen: bis zu 200 mm
- Bestimmung von Leckströmen, Durchbruchspannungen und Dielektrizitätskonstanten von Isolatorschichten
- frei programmierbare Mapping-Skripte
3ω-Messung
- Bestimmung der thermischen Leitfähigkeit (transiente »hot wire-Methode«)
- für Messungen wird eine einfache Heizstruktur aus Aluminium auf dem Dielektrikum verwendet
- Präparation der Strukturen ist sehr einfach im Vergleich zu kontaktfreien Methoden
Nanoindentermessungen
- Anlage: UMIS Nanoindentation System (CSIRO, Australien)
- Verschiedene Eindringkörper stehen zur Verfügung: Berkovich, sphärisch, pyramidisch
- Bestimmung der Härte, des Elastizitätsmodules und der Fließspannung
FTIR – Fourier-Transformation-Infrarotspektroskopie
- Anlage: BRUKER VERTEX 80v und BRUKER IFS 66
- Analyse struktureller und chemischer Materialeigenschaften, speziell für low-k Materialien, Änderungen innerhalb des Si-O-Si Netzwerks, Schädigungs- und Ausheileffekte, Zersetzung von Porogenen etc.
–
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme