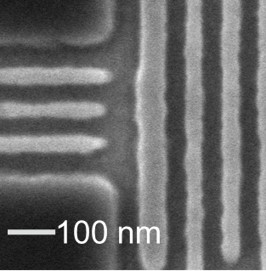
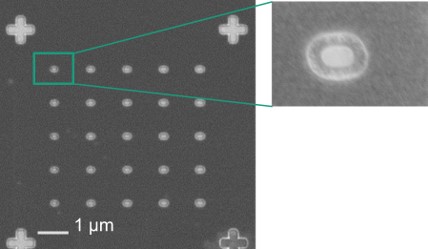

Für die Elektronenstrahllithografie am Fraunhofer ENAS steht ein Vistec SB254 Formstrahlschreiber mit 50 kV Beschleunigungsspannung und 12 A/cm² Stromdichte zur Verfügung. Damit können Nanostrukturen bis zu 40 nm Breite auf verschiedensten Substraten für verschiedenste Anwendungen realisiert werden, z.B.:
- In der Optik
- Photonik (optische Gitter, 2.5D-und 3D-Strukturen, Graustufen-Strukturen)
- Mikro-/Nanoelektronik
- Mikro-Elektro-Mechanische-Systeme (MEMS)
- Nano-Elektro-Mechanische-Systeme (NEMS)
- Mikro-Opto-Elektro-Mechanische-Systeme (MOEMS),
- Mastering/Masterherstellung für die Nano-Imprint-Lithographie (NIL)
Bearbeitbare Substrate:
- 4“, 6“, 8“ Semi Std. Si oder GaN Wafer
- 4“, 6“, 8“ Wafer mit Dicken im Bereich von 0.5 mm bis 1.5 mm
- Transparente Substrate
- Weitere Substrate auf Anfrage
Je nach Kundenwunsch und -spezifikation kommen verschiedene Lacksysteme (Positiv- und Negativlack, …) zum Einsatz um den gewünschten Anforderungen z.B. für Trockenätzen oder Lift-Off Anwendungen optimal gerecht zu werden. Die dafür nötigen Layoutanpassungen, Optimierungen in der Belichtung sowie beim Ätzen werden In-House durchgeführt um bestmöglich aufeinander abgestimmt zu sein.
Die Durchführung von Overlaybelichtungen mit der Ausrichtung an globalen Marken sowie Chipmarken ist dabei ein wesentlicher Bestandteil unserer Arbeiten und kommt z.B. oft für Transistoranwendungen zum Einsatz, bei denen Source-Drain und Gate optimal ausgerichtet sein müssen.
Weiterhin kann durch den Einsatz der Nano-Imprint-Lithographie (NIL) für Strukturgrößen im Nanometerbereich auch eine kosteneffektive Herstellung bei einer größeren Waferanzahl realisiert werden. Auch Mix- and Match Belichtungen von Elektronenstrahl- und UV-Projektionsbelichtung stellen eine Möglichkeit für effiziente Belichtungszeiten zur Realisierung von Nanostrukturen dar.
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme