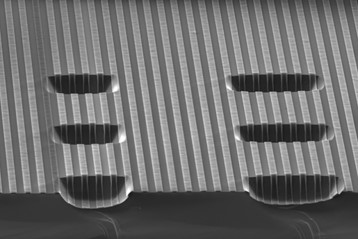
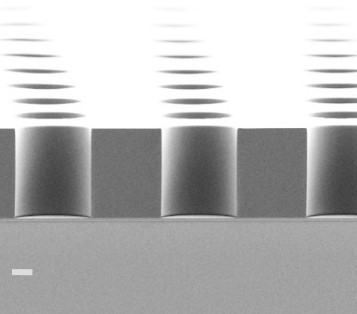
Zur UV-Kontakt- und Proximitybelichtung wird ein Mask Aligner MA200 der Firma SUSS MicroTec verwendet. Dieser verfügt über zwei verschiedene Justagesysteme: Vorderseiten- und Rückseitenjustage (Frontside- und Backside Alignment). Um den Schutz von doppelseitigen Strukturen wie bei MEMS zu gewährleisten, werden die Substrate mit einem Edge-Handling-System durch die Anlage transportiert und prozessiert. Im Anschluss an die Belichtung werden die belackten Substrate mittels Tauch- oder Puddle-Entwicklung entwickelt.
Vor der Belichtung müssen die 150 mm und 200 mm Substrate (Si-Wafer, Glaswafer, Verbunde aus Si-Si oder Glas-Si …) belackt werden. Dies erfolgt mittels Spin-On oder Sprühbelackung. Es kommen sowohl Positiv- als auch Negativlacke zum Einsatz, mit denen Schichtdicken von ca. 900 nm bis 60 µm (100 µm SU-8) erreicht werden. Trockenfilmresiste können ebenfalls mittels Laminieren auf Wafern genutzt werden. Die erzeugten Lackmasken werden für die verschiedensten Nachfolgeprozesse benötigt. Hierzu zählen Nass- und Trockenätzen, Lift-Off, Galvanik (wässrige und ionische Elektrolyte), Bonden (SU-8), etc.
Highlights:
- Mix und Match Mask Aligner mit Projektionslithographie (Intralevel und Interlevel)
- Doppelseitenlithografie (auch in Kombination mit Stepper möglich)
- Sprühbelackung (Positiv- und Negativresist)
- Belichtung in Kavitäten
- Permanent-Trockenfilmresist z. B. für Mikrofluidik- oder Bio- Anwendungen.
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme