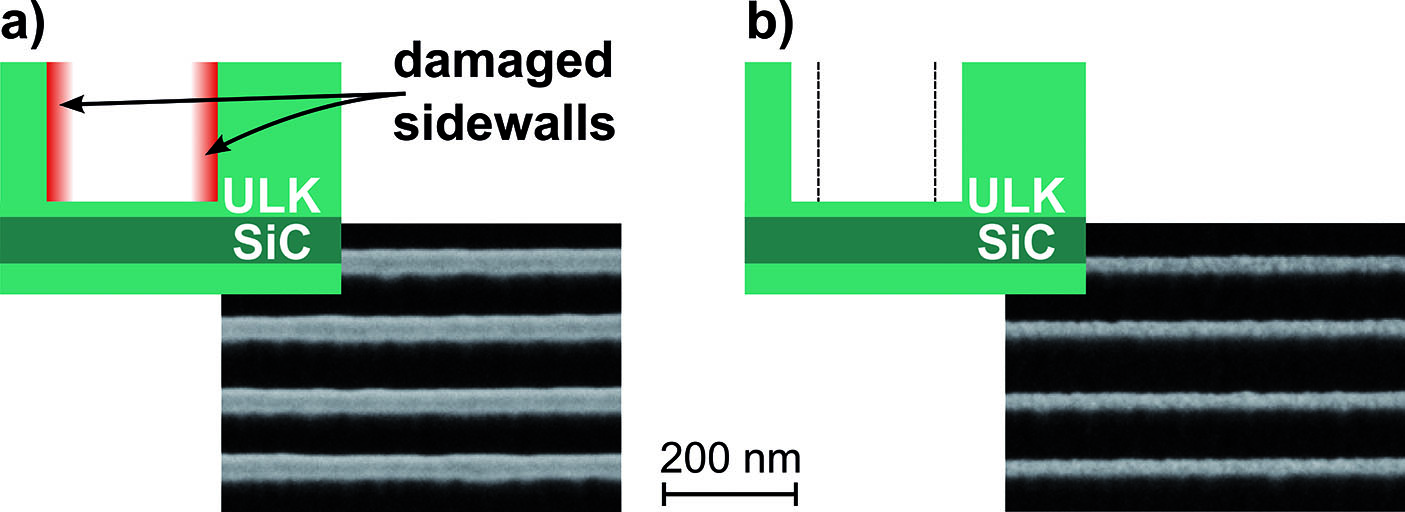
Plasmaschädigungen beim Ätzen von Ultra-low-k Materialien (ULK) können nicht vollständig verhindert werden. Die Schädigungen führen zu erhöhten Dielektrizitätswerten und somit zu höheren RC-Produkten im Leitbahnsystem. Deshalb wurde am Fraunhofer ENAS ein in situ Plasma-Reparatur-Prozess entwickelt, welcher eine bessere Reparatureffizienz aufweist als entsprechende Silylierungsprozesse. Zudem erfolgt der Reparaturprozess ohne Vakuumunterbrechung, so dass durch die Plasmaeinwirkung aufgebrochene Bindungen nicht erst durch Wassermoleküle abgesättigt werden können.
Es wurden zwei Reparaturchemien untersucht, OMCTS als sauerstoffhaltiger Präkursor und DMADMS ohne Sauerstoffbestandteile. Die Ergebnisse der theoretischen Untersuchungen, die Simulation der Fragmentierung der Präkursoren und des Reparaturprozesses an den geschädigten Bindungen stimmen mit den experimentellen Ergebnissen sehr gut überein. Der sauerstoffhaltige OMCTS-Präkursor ist besser für die Reparatur der geschädigten Bindungen geeignet und dessen Wirkung wird nochmals begünstigt durch Zumischung von O2 zum Prozessgas. Es konnte eine Reparaturwirkung von mehr als 25% erreicht werden.
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme