
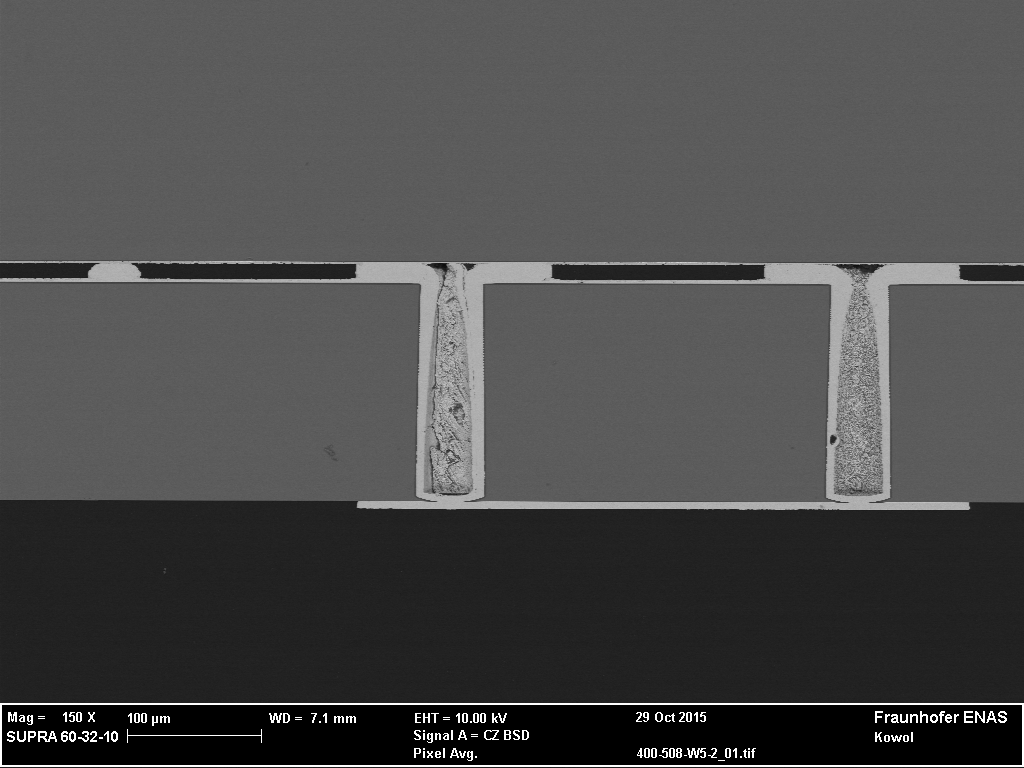
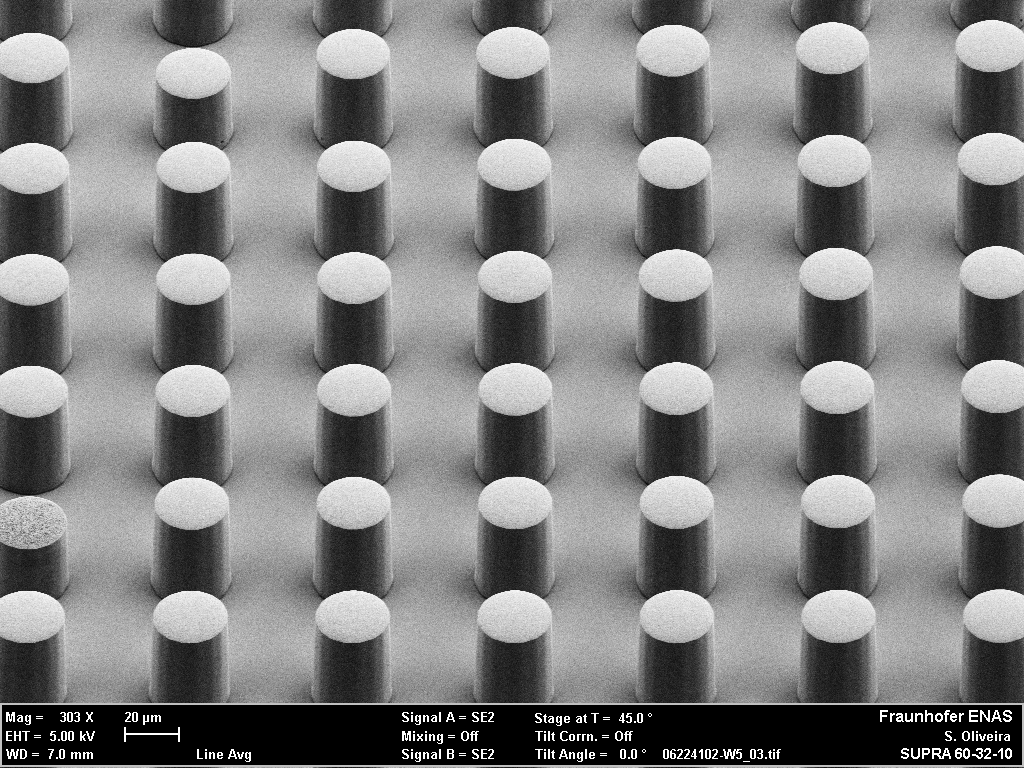
Electroplating
The electroplating of metals and metal alloys is used as a complement for CVD and PVD processes in microelectronics and MEMS technologies. Electroplating is capable of creating layer thicknesses in the range of one to several ten microns. In cooperation with the center of micro technologies of TU Chemnitz, the Fraunhofer ENAS is working on fundamental, applied and industrial research.
Research and Development
ECD is widely used to produce conductive paths in microelectronics and in MEMS components. Some significant aspects here are the Damascene technology, deposition of bonding layers (wafer bonding, chip bonding) as well as the metallization of through silicon vias (TSV) for the vertical integration of components.
Besides the water-based deposition, the electroplating from ionic liquids is also studied. The focus of research is Aluminum electroplating for applications in microelectronics, microsystem technology and in printed circuit board technology. Fraunhofer ENAS is proficient in aluminum electrodeposition on 150-mm wafers on different seed layers (Al, Cu, Au, Pt) and highly doped silicon. It can be used as electrical and thermal conductive material as well as bonding layer for wafer and chip level bonds.
 Fraunhofer Institute for Electronic Nano Systems
Fraunhofer Institute for Electronic Nano Systems