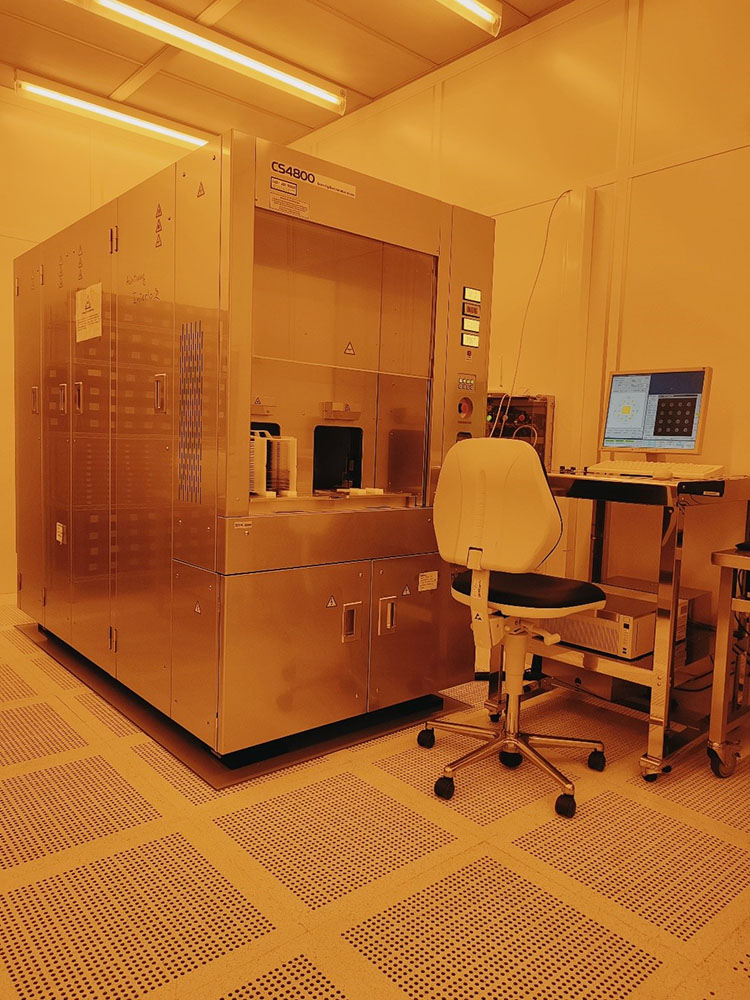
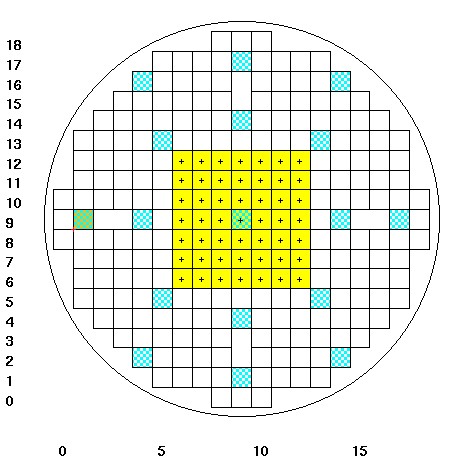
Am Fraunhofer ENAS wurde das vollautomatische CD-SEM CS4800 der Firma Hitachi installiert und ist nun einsatzbereit. Mit diesem Rasterelektronenmikroskop können vollautomatisch Messrezepte auf Wafern angelegt, vermessen und ausgewertet werden. Die mitgelieferte Bildverarbeitungssoftware ist dabei in der Lage vollautomatisch Strukturen zu erkennen, zu vermessen und nach Toleranzgrenzen zu kategorisieren.
Für statistische REM-Untersuchungen steht am Fraunhofer ENAS seit September 2022 ein Hitachi CS4800 CD-SEM zur Verfügung. Bereits seit November konnte damit für eigene Projekte die Zahl der REM-Messungen, die bisher manuell durchgeführt wurden, deutlich erhöht werden. Dies eröffnet völlig neue Möglichkeiten in Richtung Data Science. Insbesondere können Prozesse mit deutlich größerer Datenmenge auf Homogenität über den Wafer, auf Variationen von Wafer-zu-Wafer bzw. Los-zu-Los untersucht werden sowie die Strukturabweichung von Prozess-zu-Prozess.
Nachdem nun alle Schulungen erfolgt und alle Optionen installiert sind, kann Fraunhofer ENAS diesen Service seinen Kunden auch als Dienstleistung anbieten. Das CD-SEM ist dabei für Abbildungen von 6“ und 8“ Wafern für unterschiedliche Waferdicken (275 µm bis 825 µm) ausgelegt. Diese werden direkt aus dem Pod geladen, sodass auch große Stückzahlen effizient charakterisiert werden können (bspw. 40 Wafer/h bei 5 Messpunkten/Wafer). Auch transparente Substrate können gehandelt und abgebildet werden. Mit einer Auflösung von bis zu 2 nm können Aufnahmen mit 4000 – 300 000 facher Vergrößerung rezeptbasiert durchgeführt werden. Die Reproduzierbarkeit liegt dabei bei 1 nm/3 sigma bzw. 1%. Das Alignment und die Fokussierung erfolgt vollautomatisch. Die Bildauswertung erfolgt mittels Bilderkennung ebenfalls vollautomatisch und erlaubt somit die schnelle statistische Charakterisierung über den ganzen Wafer.
Highlights:
- Statistische REM-Untersuchungen und Auswertung auf Waferlevel
- 6“ (Waferdicke 275 µm bis 775 µm) und 8“ (Waferdicke 725 µm ± 100 µm) Wafer aus Silizium und Glas
- Sondersubstrate auf Anfrage
- Auflösung bis zu 2 nm
- Automatisierte Messprogramme und Analysen
- Defect Review Package / KLARF/KRF Interface zur gezielten Analyse von bereits bekannten Defekten
- Microscale mit 100 nm Pitch
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme