Inline Metrology CD-SEM Hitachi CS4800
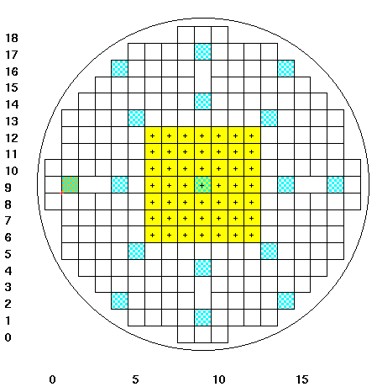

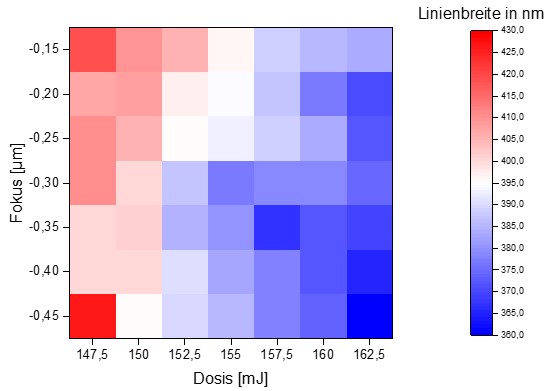
Für statistische REM-Untersuchungen steht ein Hitachi CS4800 CD-SEM für Abbildungen von 6“ und 8“ Wafern für unterschiedliche Waferdicken (275 µm bis 825 µm) zur Verfügung. Diese werden direkt aus dem Pod geladen, sodass auch große Stückzahlen effizient charakterisiert werden können (bspw. 40 Wafer/h bei 5 Messpunkten/Wafer). Auch transparente Substrate können gehandelt und abgebildet werden. Mit einer Auflösung von bis zu 2 nm können dabei Aufnahmen mit 4000 - 300 000 facher Vergrößerung rezeptbasiert durchgeführt werden. Die Reproduzierbarkeit liegt dabei bei 1 nm/3 sigma bzw. 1%. Das Alignment und die Fokussierung erfolgt dabei vollautomatisch und die Bildauswertung erfolgt mittels Bilderkennung ebenfalls vollautomatisch und erlaubt somit die schnelle statistische Charakterisierung über den ganzen Wafer.
Highlights:
- Statistische REM-Untersuchungen und Auswertung auf Wafer-level
- 6“ (Waferdicke 275 µm bis 775 µm) und 8“ (Waferdicke 725 µm ± 100 µm) Wafer aus Silizium und Glas
- Sondersubstrate auf Anfrage
- Auflösung bis zu 2 nm
- Automatisierte Messprogramme und Analysen
- Defect Review Package / KLARF / KRF Interface zur gezielten Analyse von bereits bekannten Defekten
- Microscale mit 100 nm Pitch
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme