

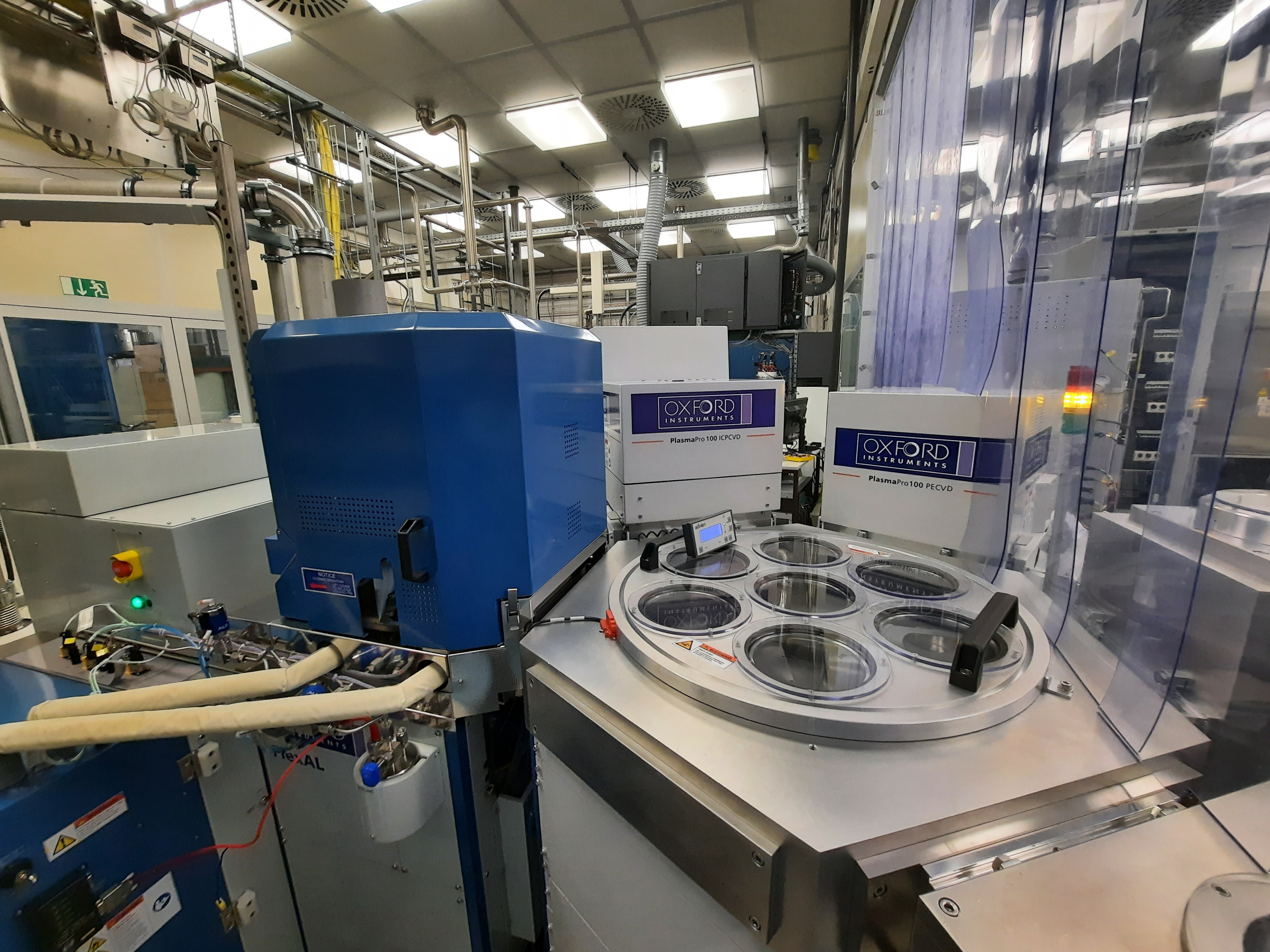
Am Institut gibt es umfassende Erfahrungen auf dem Gebiet der chemischen Gasphasenabscheidung (CVD) von Metallen und Dielektrika für verschiedenste Anwendungen. Dabei erfolgen, neben der Nutzung industriell etablierter Prozesse und Präkursoren, auch die Präkursorevaluation, die Prozessentwicklung und die Optimierung der Prozessparameter zur gezielten Anpassung der Schichteigenschaften. Die aktuelle Ausstattung ermöglicht sowohl plasmavermittelte als auch thermisch induzierte CVD-Prozesse.
Die mittels CVD abscheidbaren Dielektrika dienen dem Einsatz innerhalb oder zwischen Leitbahnebenen integrierter Schaltkreise, als Diffusionsbarrieren, Stopp- und Hartmasken-Schichten für die Strukturierung, funktionale, Deck- und Schutz-, Opfer- oder als verspannte Schichten für die Steigerung der Mobilität von Ladungsträgern im MOS-Transistorkanal. Je nach Anwendung dielektrischer Schichten bedarf es einer Optimierung der Eigenschaftsprofile. Im Mittelpunkt derartiger Untersuchungen stehen sowohl Prozesskompatibilität und Integration dielektrischer Schichten als auch einzelne Kenngrößen, wie die elektrischen, optischen, mechanischen und thermischen Eigenschaften.
CVD-Prozesse werden auch für die Metallisierung von Interconnect-Systemen als Alternative zu PVD-Verfahren und Galvanik genutzt, beispielsweise in der MEMS-Fertigung für die 3D-Integration mittels Through Silicon Vias (TSV). Die Abscheidung von Kupfer in einem thermischen MO-CVD-Verfahren mit dem Präkursor CupraSelect™ dient der Bildung einer Seed-Layer für elektrochemische Prozesse, der Metallisierung von TSVs oder der Metallisierung von Leitbahnen. Titannitrid kann mit dem Präkursor Tetrakis-(diethylamido)-titan (TDEAT) beispielsweise als Diffusionsbarriere für Kupfer abgeschieden werden.
Für die thermische oder plasmainduzierte Abscheidung von Siliciumoxid, Siliciumnitrid und Siliciumoxynitrid steht eine Prozessanlage von Applied Materials P5000™, geeignet für 150 mm-Wafer, zur Verfügung. Das vorhandene Oxford-Cluster mit PlasmaPro 100 PE- (Plasma Enhanced) und PlasmaPro 100 ICP-CVD-Kammer (Inductively Coupled Plasma) für bis zu 200 mm große Wafer ermöglicht die Abscheidung von Siliciumoxid, Siliciumnitrid und Siliciumoxynitrid. Ist eine gute Kantenbedeckung erforderlich, erfolgt die Abscheidung aus Tetraethylorthosilikat (TEOS). Eine Plasma-Therm Kobus, mit ihren vier Kammern für 200 mm-Wafer, ermöglicht sowohl Vorbehandlung/Ätzen, als auch Kupfer-, Kobalt- und Titannitrid-CVD-Prozesse.
Kompetenzen:
- plasmavermittelte und thermisch induzierte CVD-Prozesse (z.B. PE-, ICP-, LP-, MO-CVD).
- Abscheidung von Dielektrika, Halbleitermaterialien und Metallen in variabler Schichtdicke
- Entwicklung, Optimierung und Anwendung von CVD-Prozessen
- Präkursor-Evaluation / Präkursor-Screening
- Wafergrößen bis zu 200 mm Durchmesser
- Woollam-Ellipsometer für die Schichtcharakterisierung, Analyse mittels XPS
Folgende Schichten können am Institut über CVD-Prozesse abgeschieden werden:
- SiOx, SixNy, SixOyNz
- Cu, TiN, Co
- Poly-Silicium
- CF-Polymere
- DLC (diamond-like carbon)
- Parylene (N, C, D, F, AF4)
- Carbon Nanotubes (SWCNT/MWCNT)
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme