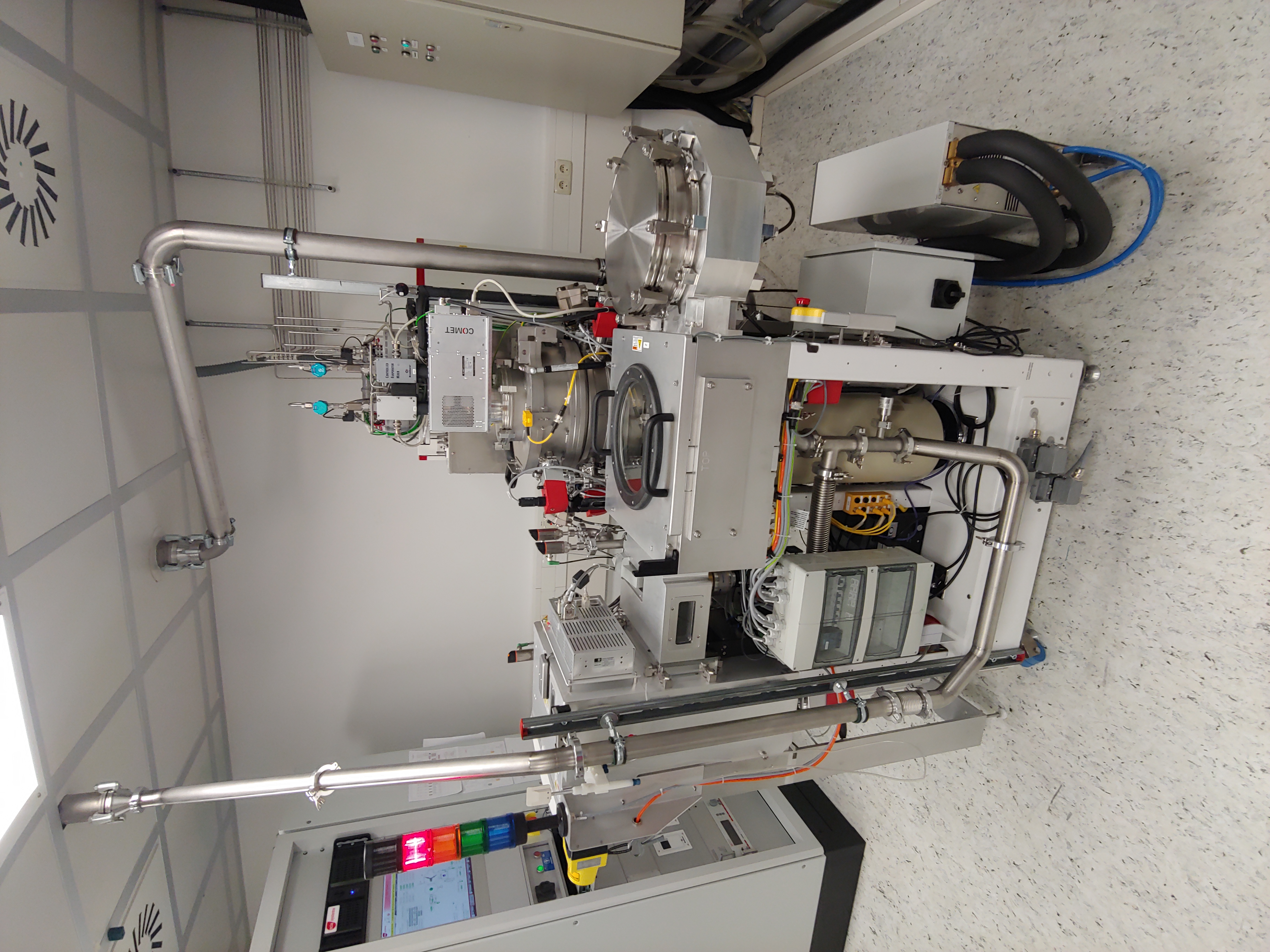
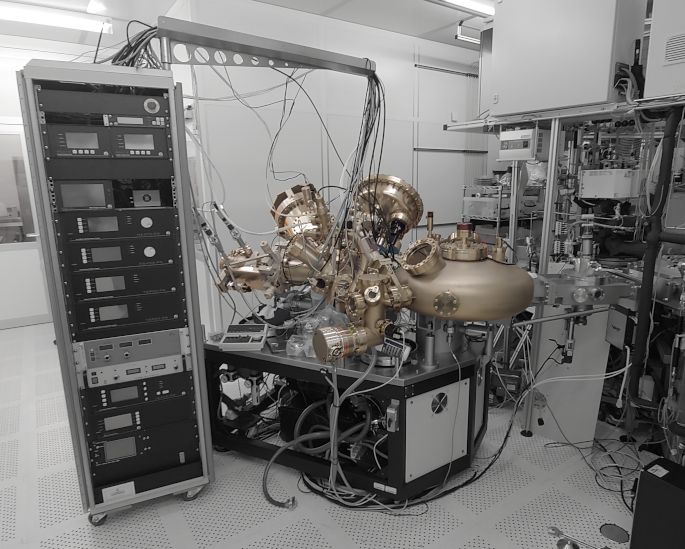
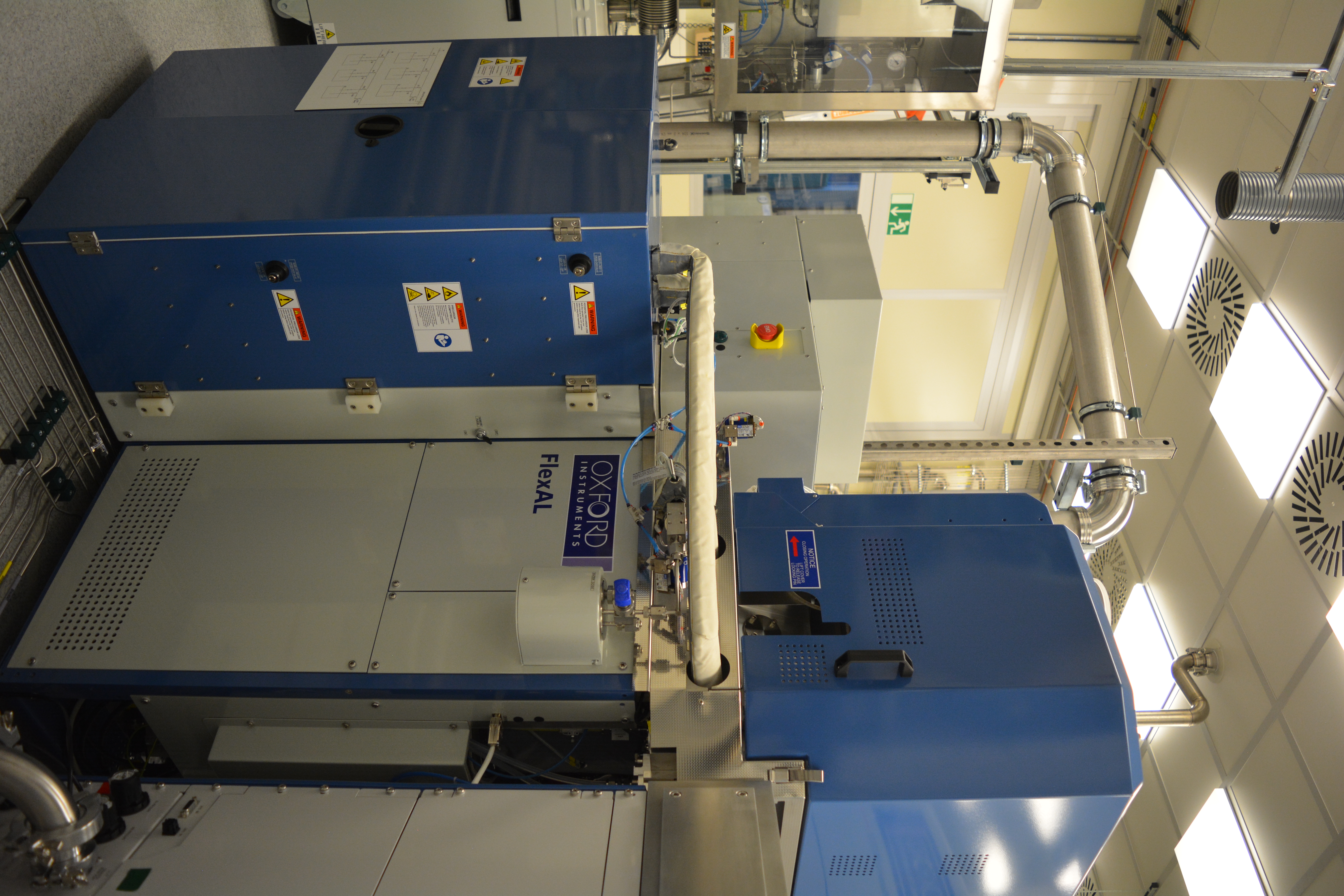
Das Fraunhofer ENAS erforscht und entwickelt seit 2006 zusammen mit dem Zentrum für Mikrotechnologien der Technischen Universität Chemnitz ALD-Prozesse für verschiedene Anwendungen. Die Tätigkeiten im Bereich der ALD umfassen die Evaluation von Präkursoren, die Entwicklung von ALD-Abscheideprozessen und die Optimierung etablierter Prozesse für die Systemintegration. Diese Schritte können durch die Simulation von Präkursoreigenschaften, Reaktionspfaden und Strömungsverhältnissen in der Reaktorkammer unterstützt werden.
Mit Hilfe der verfügbaren ALD-Prozesse werden unter anderem (high-k) Materialen, wie Aluminiumoxid, Hafniumoxid und Titanoxid abgeschieden.
Es stehen drei Prozessanlagen für die ALD zur Verfügung: Eine FlexAl-Kammer (Oxford Instruments), zwei Kammern am Roth&Rau Microcluster, und eine scia Atol200-Anlage (scia Systems). Das an der Oxford FlexAl-Kammer verfügbare Equipment ermöglicht standardisierte Prozesse mit konventionellen Bubbler-Verdampfern für Präkursoren mit hohem Dampfdruck. Die vorhandene scia Atol200-Anlage ist mit Bubblern und Direktverdampfersystemen ausgestattet, damit sowohl Präkursoren mit hohem als auch solche mit niedrigem Dampfdruck in die Gasphase überführt werden können. Die Evaluierung, Entwicklung und Optimierung von ALD-Prozess an dieser Anlage wird unterstützt durch das integrierte Ellipsometer (iSE von Woollam) sowie eine Messkammer zur kontaktlosen Widerstandsmessung (EddyCus von Suragus). Die Prozesskammern am Microcluster dienen der Prozess- und Präkursor-Evaluation. Die am System angebrachte Messkammer für Röntgen-Photoelektronen-Spektroskopie (XPS) wird zur Analyse der Zusammensetzung der abgeschiedenen Schichten ohne Vakuumunterbrechung genutzt. Das XPS steht zudem für Analysen extern präparierter Wafer zur Verfügung.
Alle Anlagen sind auf die Prozessierung von 200 mm-Wafern ausgelegt, können aber auch kleinere Substrate bearbeiten.
Kompetenzen:
- Abscheidung von oxidischen (high-k) Materialien, wie HfO2, TiO2 und Al2O3
- Abscheidung von metallischen Schichten, wie Co
- Variable Schichtdicken
- Entwicklung, Optimierung und Anwendung von ALD-Prozessen
- Präkursor-Evaluation / Präkursor-Screening
- Wafergrößen bis zu 200 mm Durchmesser
- Simulation von ALD-Prozessen, Reaktoren und Gasflüssen
- Röntgen-Photoelektronen-Spektroskopie (XPS) zur Bestimmung der Schichtzusammensetzung und Analyse von Oxidationsgrad und Bindungszuständen
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme