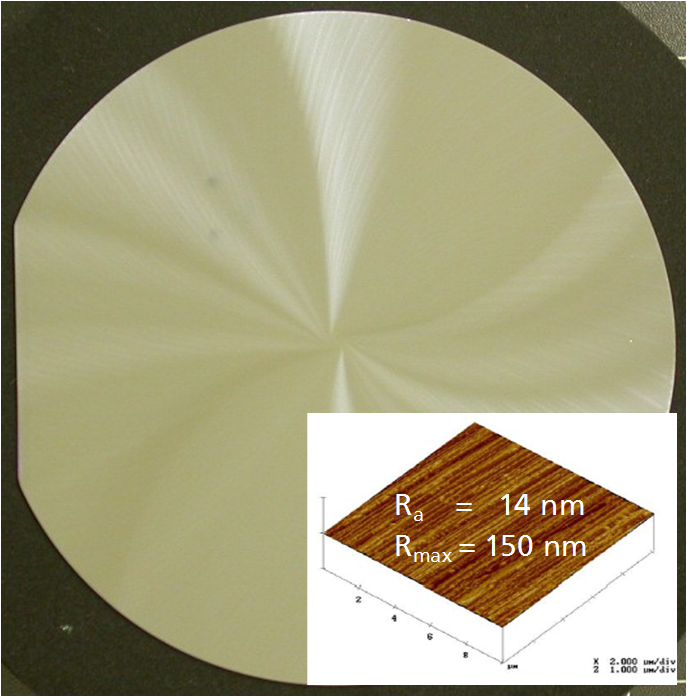
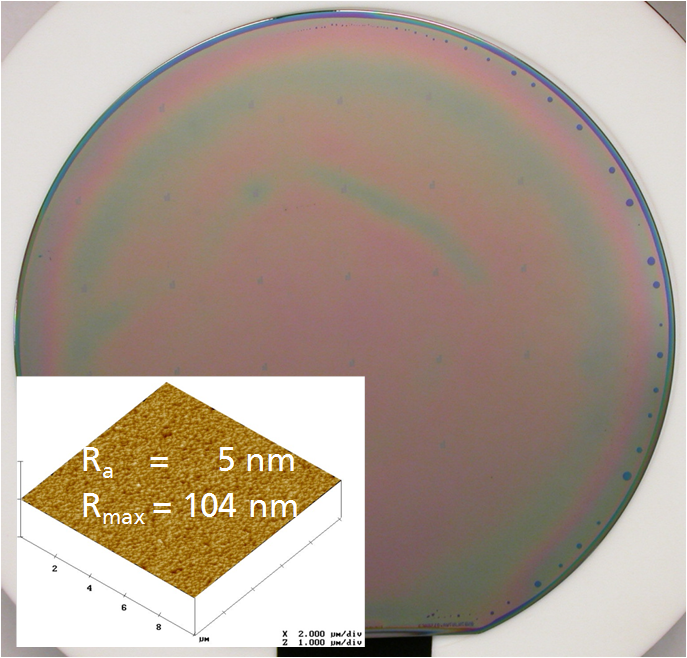
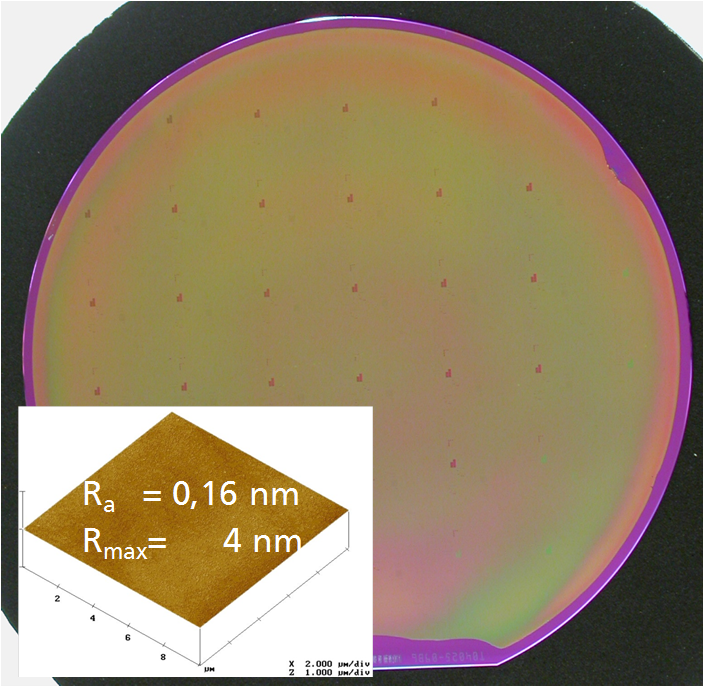
Um die Aufbauhöhe zu reduzieren und neuartige Anwendungen zu ermöglichen ist in den letzten Jahren der Bedarf an gedünnten Wafer drastisch gestiegen. Mit Dicken unter 50 μm sind diese ultradünnen Wafer biegbar, vereinfachen neuartige Anwendungen wie das Durchkontaktieren gestapelter Wafer (Through-Silicon Vias, TSV) und können auf nicht ebene Träger aufgebaut werden.
Neue Verfahren zum Waferhandling in Erarbeitung
Für das Handling solch ultradünner Wafer wurden in den letzten Jahren verstärkt neue temporäre Waferbond- und Debondverfahren erarbeitet, die bei Reduzierung der Materialdicke eine mechanische Stabilität der Wafer gewährleistet. Die Abteilung System Packaging legt dabei den Fokus auf ein adhäsives Debondverfahren, welches ermöglicht den Device vom Carrier-Wafer in einem peel-off Verfahren bei Raumtemperatur wieder zu trennen.
Adhäsives Waferbonden im Fokus
Bei dem Herstellungsprozess wird der Device zunächst auf einen speziellen Carrier-Wafer geklebt, dieser Carrier- stabilisiert den Device Wafer während des Rückdünnungsprozesses. Anschließend werden von der Rückseite die Wafer mit hoher Geschwindigkeit grob (200- 300 µm/min) und fein (1- 10 µm/min) geschliffen und so die Gesamtdicke drastisch reduziert. Dabei verursacht das Schleifen Defekte und Verspannungen im Material selbst, die die mechanische Stabilität beeinträchtigen, zu einer Verbiegung der Wafer führen und eine Rauheit Ra < 20nm aufweisen. Daher wird üblicherweise nach dem Schleifen die geschädigte Schicht mit einem chemischen Nassätz- oder plasmatechnischen Trockenätzprozess (Reactive Ion Etching, RIE) abgetragen, was zu einem Spannungsabbau, zu einer Erhöhung der mechanischen Stabilität und einer Rauheit < 10nm führt. Danach kann mit einem chemisch mechanischen Polierprozess die Oberflächengüte bis zu einer Rauheit Ra < 1nm aufbereitet werden. Abschließend wird der Carrier-Wafer entfernt, wobei spezielle Handlingsprozesse verwendet werden, um ein Brechen der jetzt dünnen und damit mechanisch instabilen Device-Wafer zu verhindern.
 Fraunhofer-Institut für Elektronische Nanosysteme
Fraunhofer-Institut für Elektronische Nanosysteme